自带“退烧”功能的集成芯片,再也不用担心手机变成暖宝宝了
小型电子器件会产生许多热量 , 只有将热量散发出去才能维持设备的性能 。 研究人员发现 , 将微流体系统集成到微芯片内部 , 展现出了卓越的冷却性能 。
提升电子系统性能的一个高效又节能的策略是将微流体冷却通道集成到芯片中 , 以防止芯片过热 。 然而 , 此前设计并构建的最先进的微流体冷却系统却是独立于电子芯片之外的 , 妨碍了将通道集成到电路中为热区提供直接的冷却 。 由于这种集成会显著增加芯片制造的复杂度 , 成本也会相应提高 。 van Erp等人在《自然》上发表论文 , 报道了一种集成微流体冷却系统的电子设备 , 让微流体冷却系统与电子元器件紧密结合 , 并且采用一种单次的低成本工艺流程进行构建 。
 文章插图
文章插图
电力电子技术使用固态电子器件将电能转换成不同的形式 , 可见于各种各样的日常应用[2] , 从计算机到电池充电器 , 从空调到混合动力汽车 , 甚至卫星 。 对更高效率、更小功率的电子器件的需求越来越大 , 意味着这些器件每单位体积转换的功率量已经大幅增加 。 这反过来又增加了器件的热流密度 , 即单位面积产生的热量 。 以这种方式产生的热量已经成为了一个大问题:美国的数据中心用于冷却计算机的能源和水与费城全城的住宅用量相同 。
微流体冷却系统在降低电子器件温度方面蕴含着巨大潜力 , 因为热量可以高效地传递到这些系统 。 总体上看 , 目前已经开发出三种微流体冷却方案 。 第一种用于冷却被保护盖盖住的芯片 。 热量从芯片经盖子传递到带有微流体通道的冷板 , 液体冷却剂会流过通道 。 这里用两层热界面材料(TIM)帮助将热量从盖子传递到冷板:一层在盖子与板之间 , 另一层在盖子与裸片(用于制作芯片的半导体硅片)之间 。
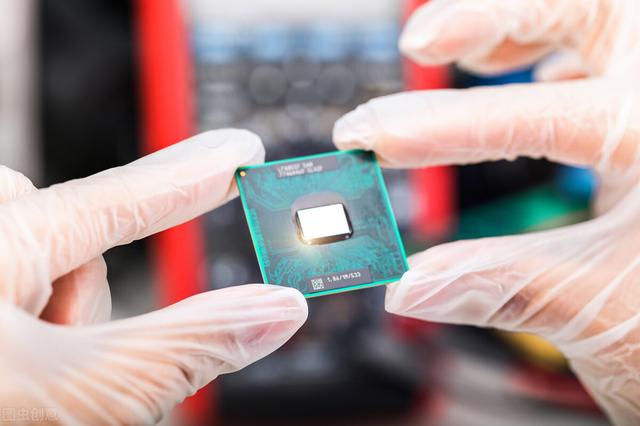 文章插图
文章插图
在第二种设计方案中 , 芯片没有盖子 , 因此 , 热量从芯片背面通过一层TIM层直接传递到微流体冷却板 。 这两种方法的主要缺点是需要TIM层——虽然TIM的设计能有效传热 , 但在TIM层与裸片、盖子和冷板之间的界面处仍会产生热流阻力 。
有效解决这个问题的方法是使冷却剂与芯片直接接触——这是第三种常用设计 。 例如 , 裸片直接喷射冷却是一种很有价值的技术 , 液体冷却剂可以从微通道中的喷嘴直接喷射到芯片背面[5–7] 。 由于没有TIM层 , 这种方法的冷却效率很高 , 并且不需要改变芯片制作过程 。 然而 , 微流体器件的制作一般比较昂贵 。 虽然已经开发出了低成本的基于聚合物的技术 , 但其不适用于电子设备目前的生产和组装工艺 。
另一种是冷却剂直接与芯片背面直接接触的方法是嵌入式液体冷却 , 让冷的液体通过直接蚀刻在半导体器件中的直的平行微管道(SPMC)泵送 。 这能有效将芯片背面变成了散热器 , 并展现出卓越的冷却性能 。 但是 , 与其他方法相比 , 裸片需要额外的加工过程 。 SPMC的主要缺点是 , 当液体流过时 , 管道中的压力会大大增加 , 这意味着需要一个大功率的泵 。 这增加了能耗和成本 , 并对半导体器件产生具有潜在破坏性的机械应力 。 另一个大的缺点是芯片上会产生高温梯度 , 这会引起热机械应力并导致薄裸片的局部翘曲 。
与SPMC相比 , 名为嵌入式分流微通道(EMMC)的三维冷却系统在降低泵送能量需求和温度梯度方面具有巨大潜力 。 在这种系统中 , 一个三维层级分流管(具有数个分配冷却剂端口的通道部件)为嵌入式微通道提供多个入口和出口 , 从而将冷却剂分流到多个平行区域 。 然而 , 将EMMC集成到电力电子器件的芯片中增加了器件制造的复杂度和成本 。 因此 , 先前报道的EMMC是作为单独的模块被设计和制作出来的 , 后续再将其结合到热源或商用芯片上以评估其冷却性能 。
- 没想到bind的功能这么强大,赶紧来看看,助你掌握新技能
- 加速编程效率,你不知道的IDEA功能设置
- 才发现!苹果手机自带会议记录神器,以后开会再也不用手写
- 国产推出运维迷你笔记本,7寸旋转屏,还自带RS-232串口
- 微信又迎来更新!4大功能接连上线,网友:都是别人玩剩下的?
- 原来微信自带扫描仪,学会这2个方法,纸质档一键电子化,很简单
- 百度地图导航路口放大图功能正式登陆特斯拉车机地图 精准导航更进一步
- Windows 10隐藏了一个控制面板功能 但你仍然可以访问它
- M1 Mac设备无法禁用电池健康管理功能
- 百度网盘推出新功能“收集文件”,免费还好用
